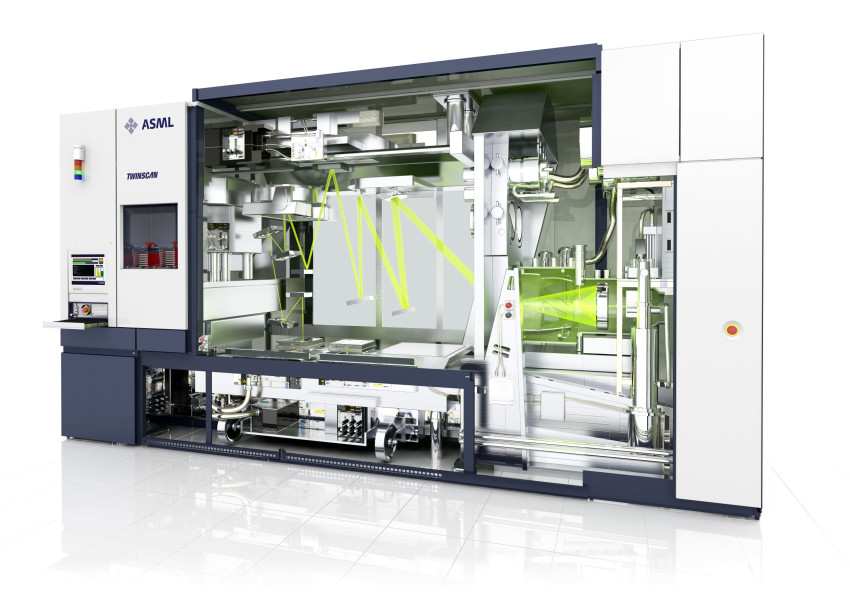
ASML doorbreekt 30 nm-grens
Met een experimentele machine die werkt met extreem ultraviolet licht, is het ASML gelukt een lijnenpatroon te etsen met een nauwkeurigheid van 28 nm. De Veldhovense onderneming verwacht begin 2010 de levering van de eerste volwaardige lithografiemachine die kortegolfbelichting gebruikt.
De huidige machines, die een laserbron bevatten met een golflengte van 193 nm, halen in een enkelvoudige belichting met een combinatie van optische trucs een lijnenpatroon met een nauwkeurigheid van hooguit 36,5 nm. ASML, wereldmarktleider in de productie van chipproductiemachines, beschouwt extreem ultraviolet licht (EUV) als het belangrijkste gereedschap om nog kleinere chips te kunnen maken.
ASML presenteerde onlangs op een conferentie in Lake Tahoe, Californië de resultaten van de tests die de afgelopen twee jaar met de eerste EUV-machines zijn verricht. ‘Op het beste deel van de siliciumwafer haalden we met alleen direct belichten een nauwkeurigheid van 28 nm’, zegt senior productmanager
dr. Hans Meiling. ‘Dat is een geweldige prestatie.’
Het gebruik van EUV brengt ingrijpende implicaties voor het ontwerp van de meeste modules in een lithografiemachine met zich mee. Lenzen zijn vervangen door spiegels en er moet worden gewerkt in vacuüm. ‘Ook de fotolak, de lichtgevoelige laag op een siliciumwafer, moet aan de kortere golflengte worden aangepast. Producenten zijn met de samenstelling ervan druk in de weer om te zorgen dat een goede lijnnauwkeurigheid is te combineren met korte productietijden. Voor een bedrijf als FujiFilm is de daarvoor benodigde research pas interessant nu er daadwerkelijk EUV-machines beschikbaar zijn.’
Dat geldt ook voor de ontwikkeling van de EUV-bron. ASML gebruikte in eerste instantie elektrische ontlading om van tin een plasma te maken. Uit het plasma wordt vervolgens straling met een golflengte van 13,5 nm geselecteerd. In de testmachine, die ASML twee jaar geleden naar het Leuvense chiplaboratorium Imec en het Amerikaanse College of Nanoscale Science and Engineering stuurde, had de ontladingsbron een continue opbrengst van 5 W. ‘Daarmee zijn ongeveer vier wafers per uur te belichten.’ Voor de productiemachine is een bron nodig die voortdurend minimaal 100 W levert. Het Amerikaanse bedrijf Cymer ontwikkelt nu een laserbron. Het prototype moet eind dit jaar klaar zijn.
Tijdens de testperiode is een aantal technische hobbels genomen. Om te voorkomen dat tin uit de bron op andere onderdelen neerslaat, maakte ASML een robuust afvoersysteem. Verder blijkt het optische bedrijf Carl Zeiss in staat om spiegels af te leveren met een oppervlakteafwijking van hooguit 0,15 nm. ‘Nauwkeurigheid van de spiegels is dus geen probleem, hooguit de kosten. Die hangen weer af van de hoeveelheid EUV-machines die we uiteindelijk kunnen leveren.’
MASKER
Het masker, waarin het patroon van de uit de siliciumplak weg te etsen laag is vastgelegd, zorgde ook voor de nodige hoofdbrekens. ‘We maken dat niet zelf, maar het hoort wel zo goed te zijn dat we de gewenste lijnnauwkeurigheid halen.’ Het masker moet met een tolerantie van 30 nm helemaal vlak zijn. Technisch lukt dat wel. Krassen zijn lastiger. ‘De producenten hebben daarvoor nieuwe polijstmiddelen ontwikkeld.’
De resultaten met de testmachines hebben ASML doen besluiten een volwaardige productiemachine te ontwikkelen, onder de naam NXE (Next EUV). ‘Het wordt, net als onze huidige Twinscan-machine, een platform waarbinnen verschillende uitvoeringen passen.’ Het platform moet 180 wafers per uur met een nauwkeurigheid van 16 nm kunnen produceren. ‘We verwachten het eerste exemplaar, dat geschikt is voor zestig wafers per uur met een nauwkeurigheid van
27 nm, begin 2010 te kunnen leveren.’
Uit de Ingenieur van 17 oktober 2008